REALMETER® 正十二烷(n-C12H26)标准漏孔
面向EUV光刻HHC污染的可溯源量化基准与管控方法(白皮书)
v1.0 | 2026-01-10
上海睿米仪器仪表有限公司|REALMETER®
文档级别:对外公开(Public)
摘要要点:本白皮书给出一种把RGA趋势信号升级为“可溯源分压”的工程方法。通过标准漏孔证书给定的输出 Q(Pa·m³/s),在同构型下建立 P_std=Q/S_eff 与响应因子 K=I/P,实现HHC相关峰的定量换算、阈值化监控与溯源诊断。

版权声明与免责声明
© 2026 上海睿米仪器仪表有限公司。保留所有权利。
本文件为对外公开(Public)版本,用于介绍 REALMETER® 正十二烷(n-C₁₂H₂₆)标准漏孔在EUV光刻HHC(可凝结有机污染物)量化管控中的原理与方法。未经书面许可,不得以任何形式复制、传播或用于商业推广以外的用途。
本文件所述方法与参数为通用工程指导,具体阈值、测点与工艺判据需结合客户工具构型(抽速/电导/测点位置/运行工况)与内部规范确定。除非合同或证书另有约定,本文不构成对特定用途的保证或承诺。
如需获取证书样例、现场导入建议或接口/流量定制方案,请联系 REALMETER® 技术支持。
文档信息与版本记录
表 1 文档信息
文档名称 | REALMETER® 正十二烷(n-C12H26)标准漏孔白皮书 |
版本 | v1.0 |
发布日期 | 2026-01-10 |
适用范围 | EUV/真空系统HHC(可凝结有机物)监测与RGA量化校准 |
联系方式 | Email: contact@realmeter.cn 电话:021-58220307, 13601764364(微信同号) |
版本变更记录
表 2 版本变更记录
版本 | 日期 | 变更说明 | 备注 |
v1.0 | 2026-01-10 | 首次对外发布版 | 对外发布版(白皮书增强) |
目录
八、结论 18
七、未来展望 18
6.2 国产EUV生态支撑价值 18
6.1 国产EUV光刻机研发阶段的潜在应用场景与预期价值 17
六、产业应用案例与价值体现 17
5.6 注意事项与维护周期 17
5.5 数据记录与报告 16
5.4 详细操作步骤 15
5.3 前置条件与工具材料 14
5.2 适用范围 14
5.1 目的 14
五、标准化操作流程(SOP) 14
4.4 核心操作流程 13
4.3 关键特性:适配EUV光刻场景 13
4.2 核心技术:质量法直接标定原理 13
4.1 经典十二烷漏孔产品介绍及核心规格 11
四、核心技术原理与操作体系 11
3.3 产业价值:建立可溯源量化基准,降低供应链与验证不确定性 11
3.2 工艺保障:筑牢EUV光刻良率防线 10
3.1 技术突破:建立HHC量化分析的底层逻辑 10
三、关键价值:从趋势判断到量化管控的能力升级 10
2.4 安全适配:无二次污染风险 10
2.3 标准统一:支撑跨产线工艺协同 10
2.2 污染溯源:实现“精准定位-靶向管控” 9
2.1 精准量化:匹配EUV光刻ppt级检测需求 9
二、核心需求:为何需要REALMETER®正十二烷漏孔? 5
1.3 传统HHC分析方法的局限性 9
1.2 HHC污染:EUV光刻的核心技术隐患 8
1.1 半导体工艺演进驱动EUV光刻成为核心支撑 8
一、行业背景:EUV光刻时代的HHC污染管控困境 5
摘要 5
常用单位换算 7
符号与单位 7
术语与缩略语表 6
表目录 5
图目录 5
版本变更记录 4
文档信息与版本记录 4
版权声明与免责声明 3
图目录
图 4 SOP流程概览:基线 → 标定 → 换算 → 监测 → 溯源闭环 15
图 3 标准化量化校准与诊断流程(示意) 13
图 2 典型安装与接口:VCR 1/4" 标配(可选 VCR→CF35/CF40 转接) 12
图 1 从标准漏孔到分压:量化链路(Q → P_std → K) 8
表目录
表 10 附录3:HHC污染判定阈值表(模板) 20
表 9 附录2:响应因子标定报告(模板-通道数据表) 20
表 8 附录2:响应因子标定报告(模板-信息页) 19
表 7 附录1:系统本底基线信号统计表(模板) 19
表 6 产品核心规格(摘要) 12
表 5 常用单位换算 7
表 4 符号定义与单位 7
表 3 术语与缩略语表 6
表 2 版本变更记录 4
表 1 文档信息 4
术语与缩略语表
本节给出本文中常用术语与缩略语的统一定义,便于跨团队复现与审计。
表 3 术语与缩略语表
缩写/符号 | 英文全称 | 中文说明 |
EUV | Extreme Ultraviolet | 极紫外光刻 |
RGA | Residual Gas Analyzer | 残余气体分析仪 |
HHC | Heavy Hydrocarbons | 重碳氢化合物/可凝结有机物(广义) |
AMC | Airborne Molecular Contamination | 空气分子污染(洁净室语境) |
CNAS | China National Accreditation Service | 中国合格评定国家认可委员会 |
VCR | VCR® metal gasket face seal | 金属面密封接头(真空洁净连接) |
CF | ConFlat® flange | 刀口法兰金属密封(铜垫) |
S_eff | Effective pumping speed | 测点处有效抽速(含电导影响) |
Q | Throughput | 吞吐量/漏率(Pa·m³/s 或 mbar·L/s) |
P | Partial pressure | 分压(Pa/mbar/Torr) |
K | Response factor | 响应因子(I/P) |
sccm | standard cubic centimeter per minute | 标准毫升每分钟(标准体积流量) |
符号与单位
本白皮书采用真空工程常用“吞吐量/漏率(Throughput)”定义:Q 的单位为 Pa·m³/s(亦常用 mbar·L/s)。下表给出全文关键符号与说明。
表 4 符号定义与单位
符号 | 含义 | 典型单位 | 备注 |
Q | 标准漏孔输出(证书给定) | Pa·m³/s 或 mbar·L/s | 通过质量法标定 |
Δm | 质量变化量 | g 或 kg | 与M单位保持一致 |
M | 摩尔质量(正十二烷) | g/mol | C12H26 ≈ 170.34 g/mol |
Δt | 计时区间 | s | 质量法测量时间窗 |
R | 气体常数 | J/(mol·K) | R=8.314 |
T | 温度 | K | T=273.15+℃ |
P0 | 标准压力 | Pa | 用于换算标准体积流量 |
S_eff | 测点有效抽速 | m³/s 或 L/s | 含管路电导/阀门影响 |
P_std | 通入漏孔后的稳态分压 | Pa 或 mbar | P_std=Q/S_eff |
I | RGA特征峰信号 | counts/s 或 A | 与RGA设置有关 |
K | 响应因子 | (counts/s)/Pa 或 A/Pa | K=I_std/P_std |
m/z | 质荷比(质量数) | amu/e | RGA质量轴 |
常用单位换算
表 5 常用单位换算
换算项 | 关系式 |
压力 | 1 mbar = 100 Pa;1 Torr ≈ 133.322 Pa |
吞吐量/漏率 | 1 Pa·m³/s = 10 mbar·L/s |
标准体积流量 | V̇_std = Q / P0(单位 m³/s @P0, T) |
摘要
随着半导体工艺向先进节点演进,极紫外(EUV)光刻对腔体与光学模块的有机污染控制提出更严苛要求。重碳氢化合物(HHC,本文主要指可凝结的重烃/有机物组分)在EUV辐照条件下可能在光学表面形成碳沉积,导致反射率下降并增加维护频率。现有现场实践多依赖残余气体分析仪(RGA)的峰形与趋势判断,难以在不同设备/不同产线之间建立可比的量化指标。REALMETER® 正十二烷(n-C12H26)标准漏孔通过质量损失法(Mass-loss)在CNAS认可实验室完成标定,提供可溯源的漏率/吞吐量 Q(Pa·m³/s)证书。将该标准信号源在既定真空构型下接入后,可建立稳态分压 P 与RGA信号 I 的响应因子 K=I/P,实现HHC相关峰的定量换算与阈值化管理,并为污染溯源、材料筛选与工艺参数优化提供可复现的工程基准。
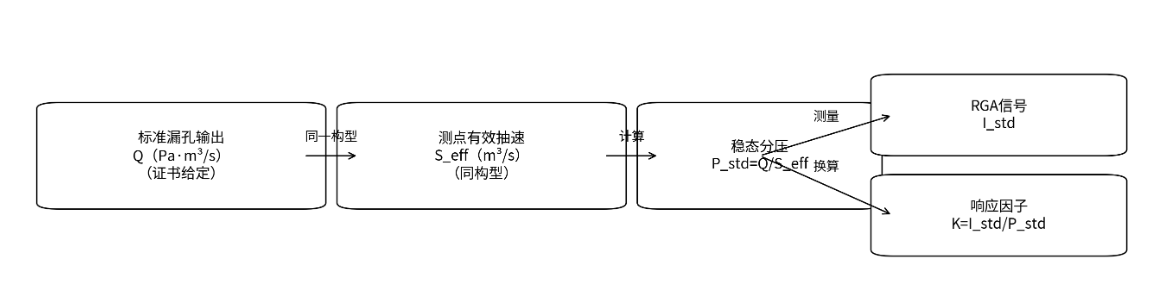 图 1 从标准漏孔到分压:量化链路(Q → P_std → K)
图 1 从标准漏孔到分压:量化链路(Q → P_std → K)
一、行业背景:EUV光刻时代的HHC污染管控困境
1.1 半导体工艺演进驱动EUV光刻成为核心支撑
全球半导体产业正朝着“更小、更快、更节能”的方向迭代,制程节点持续向更先进水平推进。在此进程中,传统深紫外(DUV)光刻在关键层面临分辨率与工艺复杂度的限制;EUV光刻凭借 13.5 nm 的短波长,在先进制程的关键层应用中发挥越来越重要的作用。
1.2 HHC污染:EUV光刻的核心技术隐患
EUV光刻系统对工作环境洁净度提出极致要求,尤其需严格控制重碳氢化合物(HHC,C₆⁺)污染。HHC主要来源于光刻胶挥发、密封件放气、管路吸附残留等环节,在EUV光子辐射作用下,会在Mo/Si多层膜光学反射镜表面发生解离聚合,形成稳定的类石墨碳膜。行业研究数据表明,仅1~3nm厚的碳膜即可导致EUV反射镜反射率下降至少1%,直接引发光刻图形线宽偏差(CD)增大、套刻精度降低,最终造成芯片良率下滑;若碳污染持续累积,还会导致光学元件不可逆损伤,显著增加设备维护成本与停机损失。
在EUV相关模块中,系统总压与局部分压会随腔体架构、抽气路径与工况变化而不同。对污染管控而言,更关键的是将可凝结有机物(HHC)在关键测点的分压控制在极低水平,并通过可复现的量化方法进行监测、对比与阈值管理。
1.3 传统HHC分析方法的局限性
在REALMETER®正十二烷漏孔问世前,半导体行业对EUV光刻HHC污染的分析普遍采用“趋势性定性判断”模式,即依赖残余气体分析仪(RGA)的峰形变化推测污染是否存在,该模式存在三大核心局限,无法适配先进制程需求:
无法定量:缺乏标准化参考基准,无法将RGA信号强度转化为具体的HHC分压或浓度数据,难以精准判断污染程度是否超出行业安全阈值;
溯源困难:无法有效区分HHC污染来源(外部泄漏、内部材料放气或光刻胶产气),导致污染管控陷入“被动应对”困境,难以从源头解决问题;
数据不可比:不同产线、不同设备间缺乏统一的检测标准,数据偏差较大,无法为跨线工艺协同与良率分析提供可靠支撑;
随着先进工艺对污染控制要求提高,单纯依赖峰形/趋势的定性判断已难以支撑跨工具、跨产线的一致性管理。现场迫切需要一种可溯源的标准化信号源,把RGA输出(counts/s 或 A)与分压(Pa、mbar 或 Torr)建立可校准的换算关系,从而实现可比的量化判定与快速溯源。
二、核心需求:为何需要REALMETER®正十二烷漏孔?
2.1 精准量化:匹配EUV光刻ppt级检测需求
EUV相关模块对HHC的关注分压通常处于极低量级,信号易受RGA灵敏度、背景、本底漂移以及抽速构型影响。为获得可比的定量结果,需要使用标准化物质建立“信号强度-分压”的换算关系。REALMETER® 正十二烷标准漏孔可提供CNAS可溯源的漏率/吞吐量 Q 证书(典型可定制范围 1×10⁻¹⁰~1×10⁻⁴ Pa·m³/s;1 Pa·m³/s = 10 mbar·L/s),作为HHC定量分析的基准输入。
2.2 污染溯源:实现“精准定位-靶向管控”
通过在相同真空构型下建立响应因子,并结合工艺阶段、温度/抽速变化、以及多碎片峰比值(例如 m/z=43/57/71/85 的相对关系),可显著提升对外部泄漏、材料放气与工艺产气等来源的区分效率。上述判定应与检漏、材料替换或工艺复核等手段形成证据链,以获得可审计的溯源结论。
2.3 标准统一:支撑跨产线工艺协同
REALMETER® 正十二烷漏孔配备CNAS可溯源证书,标定过程采用质量损失法直接溯源至国际单位制(SI)中的质量基本量。证书给出的实际漏率/吞吐量 Q 为使用基准;证书不确定度(通常以 k=2 给出)以证书为准,典型可做到≤0.5%。需注意:漏孔可按目标值定制,制造偏差可能高于证书不确定度,但最终以证书给出的实际值进行量化计算与数据对比。
2.4 安全适配:无二次污染风险
正十二烷化学惰性良好,在室温具有一定蒸气压(例如 23 °C 约 13 Pa;随温度升高而上升),无需额外加热即可形成稳定释放。作为标定介质,其主要作用是提供可重复的有机物指纹与可溯源的输入量;使用过程中需按SOP进行预抽与洁净管理,以减少外部污染引入与记忆效应。
三、关键价值:从趋势判断到量化管控的能力升级
3.1 技术突破:建立HHC量化分析的底层逻辑
REALMETER®正十二烷漏孔的核心突破,在于将“质量法直接标定”技术与EUV光刻HHC分析场景深度适配,构建起“标准漏率-稳态分压-信号强度”的完整量化逻辑链,具体实现路径如下:
通过质量法精准称量单位时间内正十二烷的质量损耗,结合其摩尔质量及理想气体状态方程直接计算漏率,规避间接法的累积误差;
漏孔释放的正十二烷在EUV腔中经分子泵抽排,形成稳定的稳态分压(P=Q/S,其中Q为漏率,S为分子泵抽速);
基于稳态分压(P)与RGA特征峰信号强度(I)建立响应因子模型(K=I/P),可将实际工况中的RGA信号直接转化为HHC分压,实现从“定性判断”到“定量计算”的本质跨越。
与传统定性分析方法相比,REALMETER®量化方案的技术优势显著,具体对比如下:
3.2 工艺保障:筑牢EUV光刻良率防线
REALMETER®正十二烷漏孔的量化分析能力,为EUV光刻工艺提供全流程洁净度保障,其核心价值主要体现在以下三方面:
光学元件保护:通过量化监测建立洁净度阈值与预警机制(阈值应依据工具规格、测点位置与反射率容许度确定),在污染接近阈值前触发维护与排查,降低不可逆沉积风险。
工艺优化:基于量化数据评估烘烤、抽气路径与材料选择对HHC的影响,缩短问题定位时间,并为烘烤策略、泵组配置与材料导入提供数据依据。
良率与稳定性:通过减少HHC波动带来的工艺漂移风险,提升跨批次稳定性;具体收益应结合客户工具构型与工艺数据进行评估。
3.3 产业价值:建立可溯源量化基准,降低供应链与验证不确定性
在高端标准漏孔与超低流量基准件领域,行业普遍采用第三方溯源与证书体系以满足审核与复现要求。REALMETER® 通过质量损失法标定与工程化设计,提供面向气体与可凝结有机物的标准漏孔方案,并可按客户构型输出标定证书与使用指南,便于快速导入与审计。
产品体系可覆盖常见惰性气体/工艺气体以及可凝结有机物(如正十二烷等)的单介质标准漏孔,并可按需求提供接口与阀门配置。对比维度(稳定性、可重复性、证书不确定度、交付一致性)建议以可验证数据与证书为准。
溯源体系:依托CNAS认可实验室,提供符合审核要求的溯源证书与记录链条,便于复现与审计。
定制能力:可根据客户需求定制3×10⁻⁶~3×10⁻⁹ Pa·m³/s等全量程漏率,适配不同工艺场景;
交付与服务:通过本地化交付与定制化支持,降低交付周期与综合导入成本(具体以项目配置与现场条件为准)。
该漏孔方案的价值在于:为EUV相关模块的HHC监测提供可溯源的标准输入与可复现的量化流程。在研发与量产导入阶段,可用于洁净度设计验证、真空系统性能评估、材料/部件放气筛选与维护触发条件的建立,从而提升问题定位效率与跨工具数据一致性。具体导入路径与收益应结合客户工具架构、测点位置、抽速构型与工艺数据进行评估。
四、核心技术原理与操作体系
4.1 经典十二烷漏孔产品介绍及核心规格
REALMETER®十二烷(C₁₂H₂₆)标准漏孔,是专为半导体EUV光刻HHC污染量化管控设计的核心基准器件,采用微通道毛细管制作工艺,具备稳定可靠、场景适配性强等特点。
其核心规格参数(经典漏率)如下:

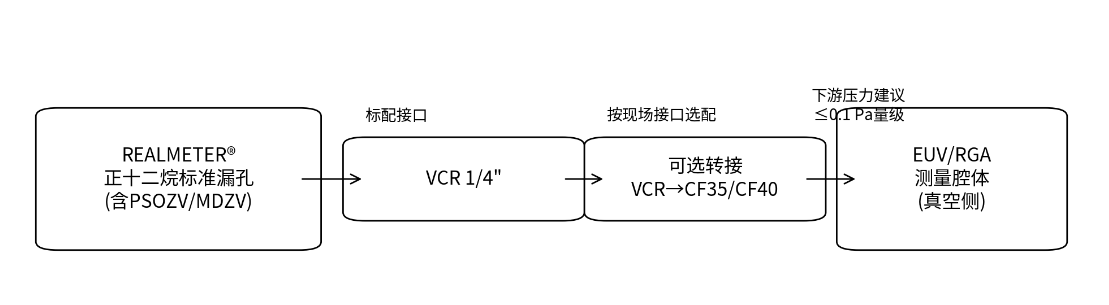
图 2 典型安装与接口:VCR 1/4" 标配(可选 VCR→CF35/CF40 转接)
表 6 产品核心规格(摘要)
项目 | 规格/说明 |
型号规格 | 典型型号RM5C123.0-6 Pa,支持定制化生产; |
核心漏率(证书值) | 典型 3.0 × 10⁻⁶ Pa·m³/s(23 °C,约 3.0 × 10⁻⁵ mbar·L/s);可定制范围 1 × 10⁻¹⁰~1 × 10⁻⁴ Pa·m³/s。制造按目标值控制(目标偏差可达±30%),但使用以CNAS证书给出的实际值为准;证书不确定度典型≤0.5%(以证书为准)。 |
填充介质 | 正十二烷(C₁₂H₂₆),化学惰性优异,无二次污染风险; |
制作工艺 | 微通道毛细管结构,确保漏率稳定性; |
关键部件 | 配备 1 个 REALMETER® PSOZV™ 常闭气动阀(可选配 MDZV™ 等配置,按项目需求);驱动气压 0.4-0.6 MPa;兼容 4 mm 或 6 mm 气管。 |
真空连接 | 标配 VCR 1/4" male;可选配 VCR-to-CF35/CF40 转接件或按项目定制CF接口。 |
物理尺寸 | 235 mm(高) × 100 mm(最宽),结构紧凑便于安装; |
使用条件与预处理 | 下游(真空侧)压力建议低于 0.1 Pa(约 1 × 10⁻³ mbar);输出对温度敏感,建议控制环境温度并根据证书/温度修正曲线进行修正。首次使用建议预抽约 2 h(或直至本底稳定);日常使用预抽约 10 min 可完成校准;若系统破真空或更换管路,应重新预抽并重建基线。 |
4.2 核心技术:质量法直接标定原理
REALMETER® 正十二烷漏孔采用质量损失法(Mass-loss)进行直接标定:通过高精度称量在已知时间窗口内漏孔释放介质的质量损耗 Δm,换算得到摩尔流量,并结合理想气体状态方程得到漏率/吞吐量 Q。该方法以“质量”作为基准量,可直接追溯至SI质量基本量,避免间接法的累积误差,适合为RGA定量建立可审计的基准输入。
核心公式(漏率/吞吐量,Throughput):Q = (Δm / (M × Δt)) × R × T
公式说明:Q 为漏率/吞吐量(Throughput,单位 Pa·m³/s),Δm 为称量时间窗口内的质量损耗(kg 或 g,需与 M 的单位一致),M 为摩尔质量(kg/mol 或 g/mol),Δt 为称量时间(s),R 为气体常数(8.314 J/(mol·K)),T 为绝对温度(K)。单位换算:1 Pa·m³/s = 10 mbar·L/s。若需要标准体积流量(m³/s@P₀,T),可由 V̇_std = Q / P₀ 计算,其中 P₀ 为标准压力(Pa)。
标定过程在CNAS认可实验室完成,核心环境要求:温度23±0.1℃、相对湿度45±2%RH,洁净度达ISO 5级;采用1μg级高精度电子天平完成称量,标定结果可直接追溯至国家计量基准,确保溯源权威性与数据可靠性。
4.3 关键特性:适配EUV光刻场景
漏率特性:漏率不可调节,但可定制3×10⁻⁶~3×10⁻⁹ Pa·m³/s等全量程规格,常温下(蒸气压13 Pa)即可稳定释放分子流,无需额外加热;
稳定性:年漏率漂移典型<1%(以产品与使用条件为准),适合长期基线维护与对比分析。
兼容性:主体采用 316L 不锈钢与金属密封体系;真空接口可为 VCR 或 CF(通过转接件或定制实现),连接管路建议采用电解抛光不锈钢管/波纹管,尽量避免有机材料与死角。
安全性:正十二烷化学惰性高,与半导体核心材料无反应,无二次污染风险。
4.4 核心操作流程

图 3 标准化量化校准与诊断流程(示意)
基于REALMETER®正十二烷漏孔的HHC量化分析,核心操作流程分为“设备连接-基线建立-定量计算-污染溯源”四步,确保操作标准化、结果可复现且可靠,具体流程如下:
设备连接:采用内壁电解抛光的 316L 不锈钢波纹管/管件,将漏孔连接至RGA采样口附近(尽量距离短、少弯、少死角),避免管路体积与记忆效应导致信号失真;通过氦质谱检漏仪验证连接密封性,连接漏率目标建议≤1×10⁻¹⁰ Pa·m³/s(或按客户规范)。
基线建立:① 本底基线:关闭漏孔,连续采集一定时长(建议≥30 min)的HHC相关峰信号(如 m/z=43/57/71/85),记录本底均值与波动(标准差);② 标准基线:打开漏孔,待代表峰与相关峰进入稳态后采集数据,得到稳态信号 I_std;结合证书给出的 Q 与测点有效抽速 S_eff 计算 P_std = Q / S_eff,并建立响应因子 K = I_std / P_std;③ 判定基线:依据工具规格与工艺容许度设定 P_limit,并用 K 映射为 I_limit,定义正常/预警/超标分级区间,写入现场SOP。
定量计算:实际工况中,实时采集代表峰与辅助峰信号 I_real,扣除本底 I_bg 后,按 P_real = (I_real - I_bg) / K 计算对应分压;建议同步检查多峰一致性(峰比值与指纹一致性)以降低误判风险。
污染溯源:对比实际信号与标准基线,结合工艺阶段(如曝光/非曝光)、抽速/温度变化与多峰比值特征,形成对“外部泄漏/材料放气/工艺产气”等来源的初步判断;并与检漏、材料替换或工艺复核等手段形成证据链,输出可审计的溯源结论与处理措施。
五、标准化操作流程(SOP)
5.1 目的
规范使用REALMETER®正十二烷漏孔开展EUV光刻HHC量化分析的操作流程,确保检测数据准确、操作安全合规、结果可靠可复现,为HHC污染精准管控提供标准化技术支撑。
5.2 适用范围
适用于3nm/2nm及以下节点EUV光刻设备的HHC污染监测,涵盖漏孔连接、基线建立、定量计算、异常判定与处理等全流程。
5.3 前置条件与工具材料
前置条件:EUV腔及管路已完成 120-150 °C、24-48 h 烘烤除气(降低残留有机物与水汽);系统本底已稳定(以现场RGA噪声与基线判据为准)。RGA已预热≥2 h,质量轴校准完成(建议以惰性气体或已知参考峰校准);漏孔在CNAS校准证书有效期内(建议 1 年)。
工具材料:① REALMETER® 正十二烷标准漏孔(漏率按腔体构型与检测范围选型,建议由“目标分压 × 有效抽速”反算所需 Q,并在证书范围内选取);② 316L 不锈钢电解抛光波纹管/管件(尽量短、少弯、少死角);③ 密封与接口件:VCR 1/4" 对应密封件/扭矩工具,或 CF35/CF40 金属密封件(视现场接口而定,必要时使用 VCR-to-CF 转接件);④ 氦质谱检漏仪(灵敏度指标以现场设备为准,工作于氦通道 m/z=4,用于连接密封性验证);⑤ 无尘纸、无水乙醇(或同等级溶剂)、洁净手套、力矩扳手、洁净封帽等。
5.4 详细操作步骤
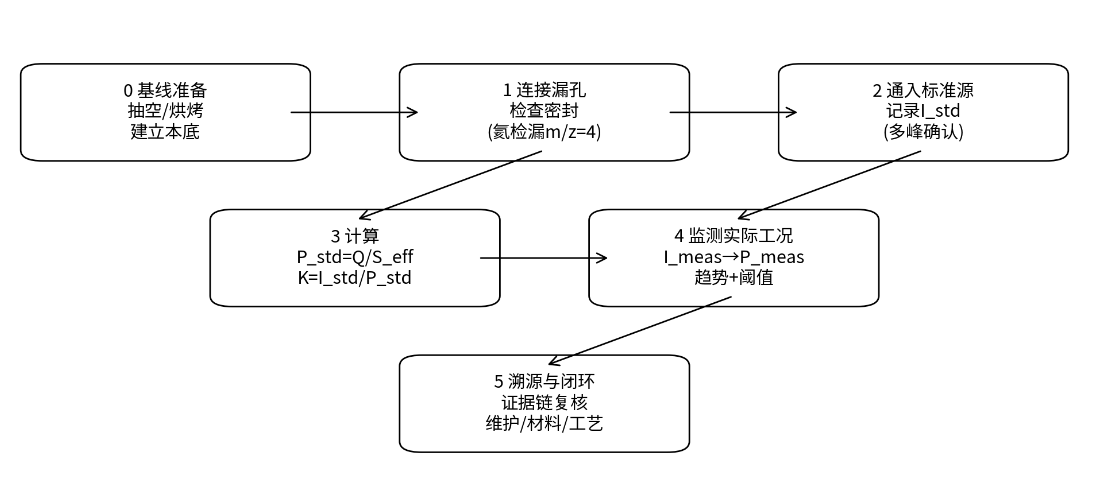
图 4 SOP流程概览:基线 → 标定 → 换算 → 监测 → 溯源闭环
步骤1:设备连接与密封性验证
部件清洁:① 预处理:用无尘纸蘸取少量无水乙醇,擦拭波纹管、法兰表面浮尘;② 超声波清洗:将部件放入超声波清洗机,加入半导体级丙酮浸泡,设置功率500W、频率40kHz,清洗15 min;倒出丙酮,更换为半导体级无水乙醇,重复清洗15 min;③ 烘干:将清洗后的部件放入高温烘箱,设置温度120℃、鼓风速率2m/s,烘烤2 h;④ 验收标准:用无尘纸擦拭部件表面,无油污残留;部件表面无水印、无划痕;烘烤后冷却至室温,立即进行下一步操作(避免二次污染);
连接布局:将漏孔通过不锈钢管/波纹管连接至RGA采样口附近,优先选择距离短、体积小、无死角的路径。按现场接口选择VCR或CF金属密封,并按对应规范使用扭矩工具均匀紧固,避免泄漏与颗粒/有机物引入。
氦质谱检漏:① 预处理:关闭漏孔通断阀(PSOZV/等效阀,仅用于通断控制),启动泵组并抽至稳定本底;② 设备设置:按检漏仪说明设置(氦通道 m/z=4);③ 检漏操作:用氦气喷枪沿接头、阀杆、焊缝等关键部位缓慢扫描,确认连接处总漏率满足现场要求(建议目标≤1×10⁻¹⁰ Pa·m³/s,或按客户规范)。
RGA参数设置:扫描范围m/z=1~200,积分时间1s/点,扫描周期30s,自动记录m/z=43、57、71、85信号。
步骤2:基线建立
本底基线:① 准备工作:关闭漏孔,待系统压力与RGA信号稳定;② 数据采集:连续采集一定时长(建议≥30 min)的HHC相关峰信号;③ 验收标准:以现场噪声水平设定阈值,要求本底均值与波动满足后续定量分辨率需求,并记录作为“本底均值/标准差”。
标准基线:打开漏孔,实时监测信号变化,待代表峰与相关峰(建议 m/z=43/57/71/85)进入稳态后采集数据。记录稳态信号均值 I_std,并结合证书给出的 Q 与测点有效抽速 S_eff 计算稳态分压 P_std = Q / S_eff;由此得到响应因子 K = I_std / P_std。建议重复标定并评估K的重复性(例如偏差≤3%,以现场需求为准),用于提升换算可靠性。
判定基线:根据工具规格与工艺容许度设定分压阈值 P_limit,并通过 K 将其映射为信号阈值 I_limit。建议定义分级区间(正常/预警/超标)并写入现场SOP,确保判定一致、可审计。
步骤3:HHC定量计算
关闭漏孔,待信号回落至本底后启动EUV工艺;
实时采集代表峰及辅助峰信号(例如以 m/z=57 为代表峰,并同步记录 m/z=43/71/85 作为一致性校验)。按 P_real = (I_real - I_bg) / K 计算对应分压(I_bg 为本底均值;K 为响应因子)。
记录工艺阶段、信号强度、分压值及污染等级。
步骤4:异常判定与处理
异常判定与处理:① 正常(1级):实时信号<21 counts/s,持续监测,每小时记录1次m/z=57信号强度、系统真空度、工艺阶段,形成趋势曲线;② 轻度异常(2级):信号21~210 counts/s,立即暂停EUV曝光工艺,保持分子泵运行,实施120 ℃梯度补充烘烤(先60 ℃预热2 h,再升温至120 ℃保温12 h);烘烤完成后冷却至工艺温度,复测HHC分压,若回落至<3×10⁻⁸ Pa(信号<21 counts/s),可恢复工艺;若复测仍不达标,重复烘烤1次,若仍异常则升级为严重异常;③ 严重异常(3级):信号>210 counts/s,立即停机(关闭EUV光源,保持分子泵低功率运行维持真空);第一步:用氦质谱检漏仪排查外部泄漏(重点检测法兰接头、管路焊缝);第二步:若未检测到外部泄漏,拆卸漏孔与RGA采样口连接管路,检查内部是否存在材料放气或污染;第三步:若管路清洁,排查光刻胶是否存在异常产气,更换光刻胶批次后重新测试;第四步:所有排查处理完成后,重新建立基线,复测HHC分压<3×10⁻⁸ Pa后,方可恢复系统运行;④ 异常记录:详细记录异常发生时间、信号峰值、工艺阶段、处置措施及效果,纳入《EUV光刻HHC量化分析日报》,作为工艺优化依据;
5.5 数据记录与报告
每日生成《EUV光刻HHC量化分析日报》,涵盖基线数据、工况数据、异常记录及处理结果;每月汇总生成趋势报告,为工艺优化提供数据支撑。
5.6 注意事项与维护周期
注意事项:① 拆装与污染防控:优先在具备隔离条件下进行(隔离阀、load-lock 等),避免直接将真空侧长时间暴露在普通环境空气中。如必须通大气,建议在洁净环境下操作,并采用超高纯氮气置换/吹扫与洁净封帽,降低水汽与有机物引入风险;拆装后按SOP重新烘烤除气并重建基线。② 工具与耗材:所有与漏孔、管路接触的工具与零件应洁净处理(溶剂擦拭、洁净烘烤或等效流程),操作中佩戴无尘手套,避免颗粒与有机残留。
维护周期:每日记录核心数据;每月复核基线稳定性;每季度复校RGA响应因子、清洗管路;每年送CNAS认可实验室复校漏孔(仍采用质量法标定);
六、产业应用案例与价值体现
6.1 国产EUV光刻机研发阶段的潜在应用场景与预期价值
在国产EUV光刻机的研发进程中,REALMETER®正十二烷漏孔有望成为核心的HHC量化管控工具,可针对性引入核心真空系统、光学模块等关键研发验证平台,助力构建全流程HHC量化管控框架。该工具能够有效破解研发阶段洁净度验证缺乏量化基准、污染溯源困难等共性难题,为国产EUV研发提供精准的污染管控技术支撑,其潜在应用价值与预期成效如下:
污染溯源效率提升:针对研发过程中可能出现的HHC异常信号,可借助漏孔建立的标准基准,快速精准判定污染来源(如密封件放气、材料残留等),规避传统定性方法的排查滞后问题,助力及时解决污染隐患;
研发验证周期优化:通过量化数据支撑腔体烘烤等工艺参数的优化,有望缩短核心真空系统洁净度达标的验证时间,提升研发验证效率,为相关模块研发进度提供保障;
核心部件保护支撑:可精准量化光学元件等核心部件测试环境的HHC污染水平,建立适配的洁净度安全阈值,减少污染导致的测试失效风险,降低研发过程中的耗材损耗与成本投入;
光刻胶研发筛选适配:在国产EUV光刻胶研发筛选阶段,可利用漏孔建立标准化HHC放气测试体系,辅助筛选低污染光刻胶型号,为光刻胶配方优化提供量化参考,避免后续研发返工;
真空系统设计优化:针对核心真空系统的泵组配置、腔体结构设计等,可通过漏孔模拟HHC污染场景,量化评估不同设计方案的污染控制能力,为优化真空系统设计提供数据支撑;
光学模块集成保障:在核心光学模块集成测试阶段,可借助漏孔构建模拟工况的HHC污染环境,验证光学模块在不同污染水平下的性能稳定性,辅助制定光学模块的洁净度验收标准,保障集成后的光学性能;
整机联调污染管控:针对整机联调阶段可能出现的多子系统复合HHC污染,可通过漏孔建立的量化分析逻辑,区分不同子系统的污染影响,辅助优化各子系统洁净度管控策略,保障整机联调顺利推进;
长期可靠性验证支撑:在设备长期稳定性测试中,可利用漏孔模拟实际工况下的HHC污染累积过程,监测污染累积对设备核心性能的影响,为设备寿命评估及维护方案制定提供参考;
国产供应链适配验证:可依托漏孔建立标准化测试平台,对国产真空管路、密封件等配套材料的HHC放气水平进行量化验证,助力筛选符合研发要求的国产材料,推动EUV产业链配套材料的国产化适配;
研发与量产标准衔接:提前依托漏孔建立研发阶段的HHC量化标准,可实现与未来量产阶段洁净度管控标准的有效衔接,为后续产业化落地奠定统一的洁净度管控基础。
6.2 国产EUV生态支撑价值
REALMETER®正十二烷漏孔有望为国产EUV光刻机研发及配套材料检测全流程提供关键量化支撑:在核心材料筛选阶段,可精准量化不同材料的HHC放气水平,为低污染材料选型提供客观依据;在真空系统研发阶段,能辅助评估系统污染控制能力,助力设计优化;在工艺验证阶段,可推动建立洁净度量化标准,保障研发成果的稳定性与可靠性。这种“研发即量化”的提前布局,不仅可为国产EUV光刻胶、光学元件等配套环节的性能验证提供可溯源的量化基准,更有助于我国在EUV研发初期构建优于国际同行的洁净度管控体系,推动产业链关键环节技术突破,助力降低对进口检测设备的依赖,为实现EUV领域的自主可控与技术赶超奠定基础。
七、未来展望
随着半导体工艺向1.4nm及以下节点演进,EUV光刻对HHC污染的管控要求将进一步升级,对量化分析工具的精度、稳定性、智能化水平提出更高要求。REALMETER®将持续深耕半导体检测领域,围绕以下方向推进技术创新与迭代:
更高精度标定:持续提升质量法标定精度,突破现有技术瓶颈,以适配更先进工艺的ppt级乃至亚ppt级超痕量HHC检测需求;
智能化分析:开发集成漏孔控制、信号采集、数据处理的一体化系统,实现HHC污染的实时监测、自动预警与智能溯源;
全品类覆盖:拓展正十二烷之外的其他HHC标准漏孔品类,满足不同污染组分的量化分析需求;
生态协同:联合高校、科研院所与产业链伙伴,推动形成可复现的测试方法与推荐实践(如选型、标定、温度修正与数据报告格式),促进EUV相关有机污染监测的工程化与标准化。
八、结论
REALMETER® 正十二烷标准漏孔为EUV相关模块的HHC监测提供了可溯源的量化基准:通过在既定真空构型下建立响应因子,将RGA信号与分压建立可校准的换算关系,从而把“趋势性判断”升级为“可复现、可对比、可审计”的量化管理方法。该方法可用于阈值设定、维护触发、材料筛选与工艺参数优化,并提升污染溯源效率。
未来,随着工具架构与工艺要求演进,HHC量化管控将更加依赖可溯源基准、稳定的工程实现与数据闭环。REALMETER® 将持续完善介质覆盖、接口与软件化流程,提升长期稳定性与现场可操作性,并与客户共同迭代更贴合量产现场的推荐实践。
附录0:符号与单位说明(建议对外发布保留)
1)漏率/吞吐量(Throughput)Q:单位 Pa·m³/s 或 mbar·L/s;换算:1 Pa·m³/s = 10 mbar·L/s。
2)稳态分压 P:单位 Pa、mbar 或 Torr;需在报告中固定单位并注明测点位置。常用换算:1 mbar = 100 Pa;1 Torr ≈ 133.322 Pa。
3)有效抽速 S_eff:单位 m³/s 或 L/s;用于 P = Q / S_eff。S_eff 需考虑管路电导与阀门开度,可在相同构型下通过标准漏孔反算或通过导通计算估算。
附录:关键数据记录模板
说明:以下表格为现场执行与审计留档模板。建议在每次系统改造、抽速/电导变化、RGA更换或维护后重新建立本底与响应因子,并将记录随报告归档。
附录1:系统本底基线信号统计表
表 7 附录1:系统本底基线信号统计表(模板)
m/z | 碎片/物种(备注) | 本底均值 Ī(counts/s) | 标准差 σ(counts/s) | 建议阈值(例如 Ī+3σ) | 采集设置/备注 |
43 | C3H7+ / 烃类代表峰 | ||||
57 | C4H9+ / 烃类代表峰 | ||||
71 | C5H11+ | ||||
85 | C6H13+ | ||||
18 | H2O(水汽) | ||||
28 | N2/CO(背景) | ||||
44 | CO2(背景) | ||||
注:建议使用同一采集参数(质量范围、驻留时间、平均次数、增益)记录本底;阈值可按 Ī+3σ 或按客户spec设定。
附录2:响应因子标定报告
表 8 附录2:响应因子标定报告(模板-信息页)
客户/项目 | |
系统/腔体编号 | |
标定日期 | |
操作员 | |
RGA型号/序列号 | |
检测器/增益设置 | |
采集参数(质量范围/驻留/平均) | |
标准漏孔证书编号(Q) | |
介质/温度/连接构型 | |
备注(S_eff估算/反算方法) |
表 9 附录2:响应因子标定报告(模板-通道数据表)
m/z | 碎片/物种 | I_baseline(counts/s) | I_on(counts/s) | I_net=I_on-I_baseline | Q(Pa·m³/s) | P_std=Q/S_eff(Pa) | K=I_net/P_std(counts/s/Pa) |
43 | C3H7+ | ||||||
57 | C4H9+ | ||||||
71 | C5H11+ | ||||||
85 | C6H13+ | ||||||
附录3:HHC污染判定阈值表
表 10 附录3:HHC污染判定阈值表(模板)
对象/模块 | 监测m/z集合 | 分压阈值 P_th(Pa) | 信号阈值 I_th(counts/s) | 触发动作(建议) | 复核/证据链 |
EUV关键光学腔体(示例) | 43/57/71/85 | 报警→保持工艺/暂停曝光待确认 | 对比本底;检查阶段相关性;必要时材料替换/外部检漏 | ||
上游供气/载气相关段(示例) | 57(代表) | 报警→检查阀组/密封/管路清洁 | He检漏(m/z=4);对比阀位与阶段;检查泵前压力 | ||
维护后恢复验证(示例) | 43/57/71/85 | 通过→恢复量产;不通过→继续烘烤/排查 | 对比维护前K与本底;确认S_eff未变化或已重标定 | ||







